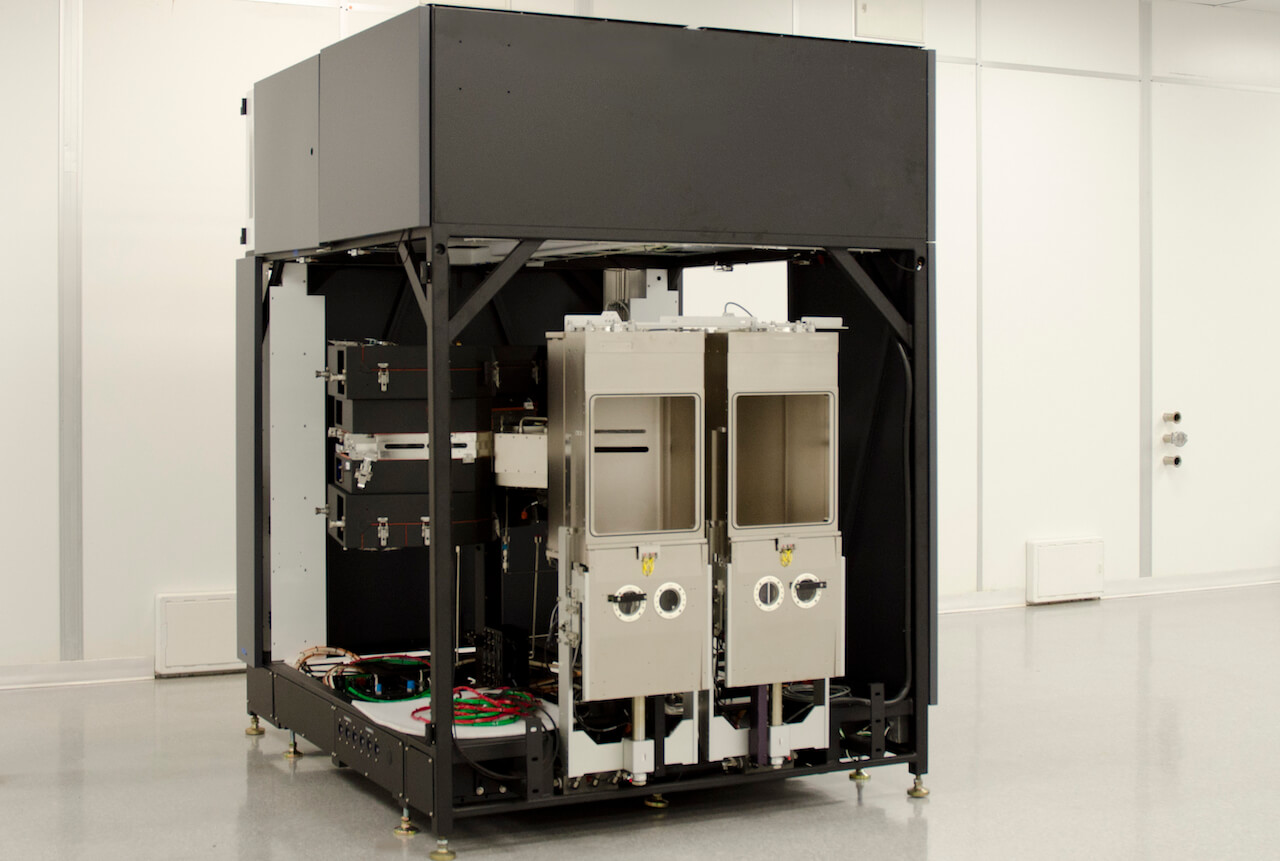
The Centura® is a single-wafer, multi-chamber system that supports processing of wafers ranging in size from 5", 6", or 8". The multi-chamber design allows for individual processes in each of the chambers.
The HTF platform may include up to 4 process chambers and 2 auxiliary chambers, depending on configuration. Some configurations only allow for 3 process chambers, and 2 auxiliary chambers.
The platform improves on the Precision 5000® design by utilizing advanced robotics and independent loadlocks to allow for higher throughput.
The Loadlocks and buffer chamber are ENP (electroless nickel plate) to reduce corrosion.
The mainframe differs from the standard Centura frame due to:
1) Mainframe skins and doors for safety and reduced noise.
2) Upper frame for housing blowers and heat exchangers.
The following chamber types can be added to the system:
RP EPI - Reduced Pressure EPI provides improved performance for autodoping, and less pattern distortion. DCS is used as the silicon source.
ATM EPI - Atmospheric Pressure EPI provides thiker EPI layers where autodoping is not as much of an issues. TCS is used as the silicon source.
Polysilicon - Deposits Doped Poly, Undoped Poly, and Amorphous Silicon. Allows for different silicon sources and dopants
Polycide - Polycide systems pairs Polysilicon chambers with Tungsten (WSix) chambers.
Nitride - High temperature Nitride deposition.
EpiClean - EpiClean is used on RP EPI systems to remove native oxides prior to epitaxial deposition.
RTP Xe - Available Nontoxic ATM, Toxic ATM, and Toxic RP configurations.
RTP Xe+ - Available Nontoxic ATM, Toxic ATM, and Toxic RP configurations.
RTP Mod 1 - Available Nontoxic ATM, Toxic NH3 ATM, and Toxic NH3 RP configurations.
SiNgen - Reduced pressure nitride process chamber.
POLYgen - Reduced pressure silicon deposition chamber.
DCSxZ-WSix - Low pressure chemical vapor deposition (LPCVD) chamber for deposition of Tungsten Silicide Oxide.
SiH4xZ-WSix - Low pressure chemical vapor deposition (LPCVD) chamber for deposition of Tungsten Silicide Oxide.
Single Slot Cooldown - Utilizes a water cooled pedestal to cool the wafer when placed in the chamber. Wafers do not contact the pedestal.
Single Slot Contact Cooldown - Utilizes a water cooled pedestal to cool the wafer when placed in the chamber. Wafers contact the pedestal, allowing for faster cooling, and higher throughput.